浏览量:9 作者:费马科仪 发布时间:2026-04-20
前言
当一块PCBA在可靠性测试中失效,当一颗LED芯片在封装后出现光衰异常,当一块智能卡模块在终端用户手中发生电气故障——工程师的第一个问题往往是:里面,到底发生了什么?
金相制样,正能回答这一问题。通过切割、镶嵌、磨抛、显微观察等步骤,将器件内部结构无损暴露,让工程师发现真实的问题所在。
本文将结合费马科仪近期制备的六个样品:LED封装、芯片晶圆、智能卡模块、底部填充胶、微型贴片元件、激光器芯片,系统分析它们在切割方式、镶嵌树脂选择、磨抛参数及观察需求方面的工艺与技术差异。
实际应用案例
以下六个案例覆盖了芯片、LED、智能卡等主要电子器件类型,展示了金相制样在不同检测目标下的技术差异。
1.LED封装与光耦


制样目标:
观察元件内部的焊线(金线/铝线)形貌、键合点状态及芯片贴装质量。
切割:使用费马科仪手自一体精密切割机(Fcut 230E),搭配碳化硅切割片,转速3000rpm,切割速度2mm/s,避免损伤脆弱引线。
镶嵌:采用低粘度、高渗透环氧树脂(F2112AB,固化50-120min),结合压力型冷镶嵌机(Epress 30V),需确保树脂充分填充器件内部微缝隙。
磨抛:使用双盘双控自动磨抛机(Fpol 252A Pro),240目→1200目→2500目→4000目砂纸逐级研磨,最终使用0.3μm氧化铝+0.05μm二氧化硅抛光。
观察:
研究级正置金相显微镜(BM100G)明场下可直接观察到金线轮廓、焊点形貌及芯片与基板的结合状态。


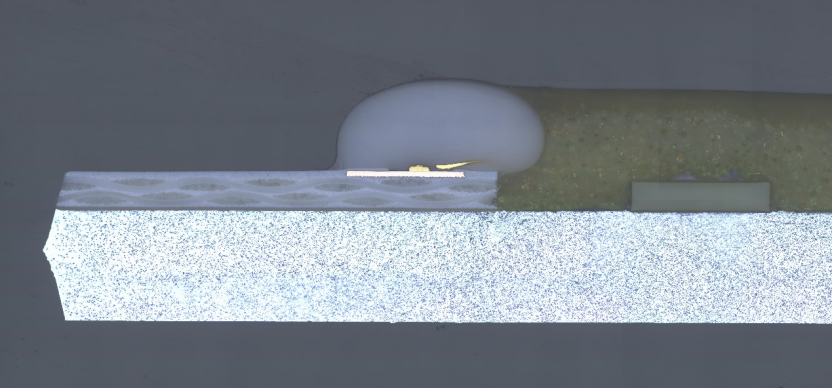

2.芯片晶圆
芯片晶圆(含硅通孔TSV或特定目标区域)


检测目标:研磨至指定红线位置(目标尺寸仅约42μm),观察截面镀层与通孔填充质量。

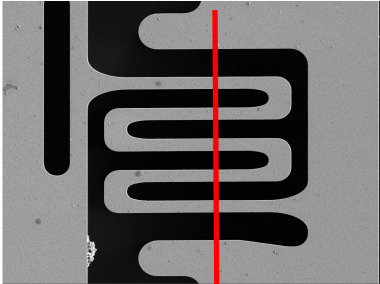
镶嵌:选用超低粘度环氧树脂(F2168AB,固化6-8h),渗透性最 佳,配合压力镶嵌(Epress 30V)完全填充晶圆与基板间的微小间隙。
磨抛:使用全自动磨抛机(Fpol 252A auto),研磨至1200目后每20秒观察一次,通过参照点定位防止磨过头,最后用1μm金刚石+0.05μm氧化铝抛光。
定位技巧:在目标旁找到参照点,通过测量参照点与目标的距离(如文档中标注42μm),在显微镜下反复比对,确认研磨位置。
观察:
研究级正置金相显微镜BM100G,500倍下可清晰量测通孔直径、镀层厚度等关键参数。


3.智能卡模块
智能卡模块(柔性基材,含金丝焊球)
检测目标:沿指定红线切开,观察焊球形貌及与载带的连接质量

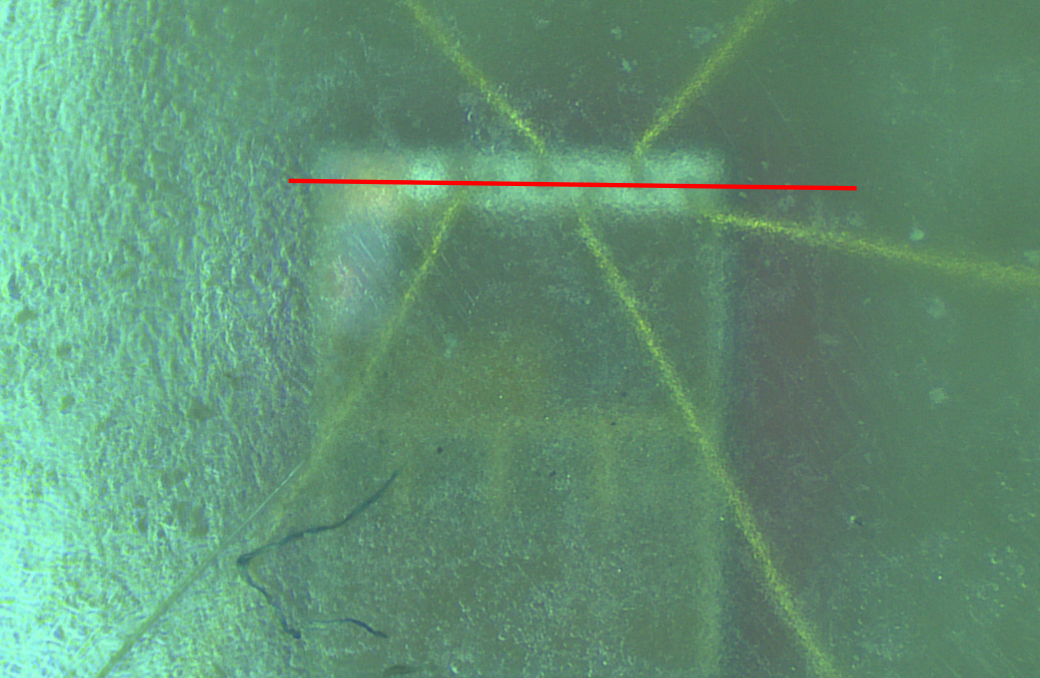
取样:因柔性卡片可弯折,使用剪刀直接裁剪,剪切位置距目标3-5mm以上,避免损伤焊点。
镶嵌:环氧树脂(F2112AB)压力镶嵌Epress 30V,保证焊球边缘无树脂收缩缝隙。
磨抛:全自动磨抛(Fpol 252A auto),逐级研磨后用0.05μm氧化铝+0.04μm二氧化硅抛光,载荷从15N降至8N,时间仅1min/步,防止软质焊球过度磨损。
观察:
研究级正置金相显微镜BM100G,500倍下焊球轮廓清晰,可评估焊球变形、空洞及与载带的润湿情况。


4.芯片底部填充
倒装芯片底部填充胶(环氧树脂)


检测目标:观察点胶填充是否完整,有无气泡、缺胶;定量评估孔隙率。
切割:手自一体精密切割机(Fcut 230E),F50A2310切割片(Φ230mm),切割片转速:2800rpm;切割速度1mm/s,避免胶层开裂。
镶嵌:先使用智能型真空镶嵌机(Fpress 30C auto)在高真空下浇注UV树脂,彻底排出微孔隙内气体;再用光固化镶嵌机(Fpress 30UV)1-2min快速固化。


磨抛:使用全自动磨抛机Fpol 252A auto,因仅需观察填充状态,研磨至2500目即可,无需抛光(客户现场评估研磨效果已满足需求)。
观察与量化:视频显微镜AFSCOPE A322(环形光源)低倍下观察整体填充情况。


若需进一步精确评估,在抛光后使用金相显微镜拼接大视野图像,使用专业孔隙率软件进行定量分析,自动识别孔洞并计算面积占比,导出量化报告。


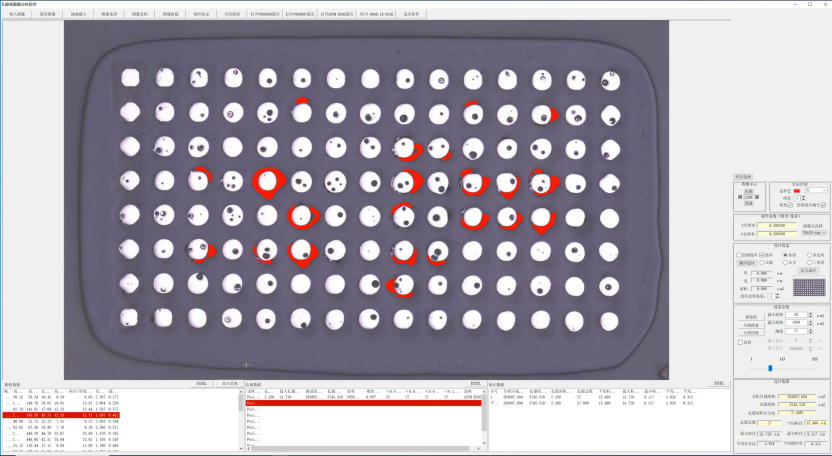

5.微型贴片电子元件
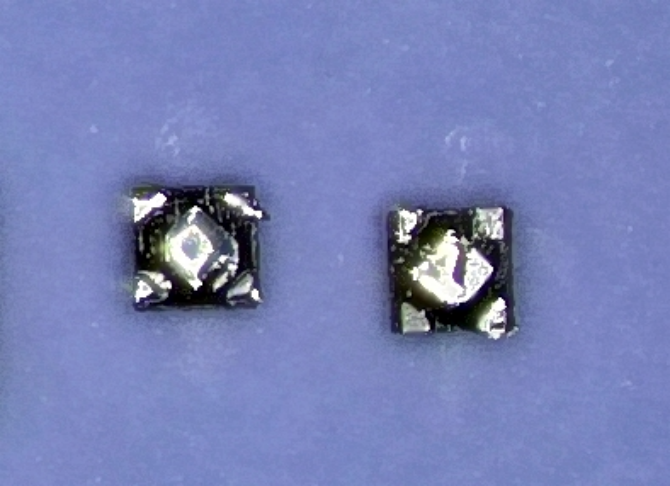

检测目标:垂直切开,观察内部多层结构(陶瓷层、电极层、焊接界面)
切割:精密切割机(Fcut 230E),搭Φ150mm树脂金刚石切割片,切割速度0.1mm/s(极慢速防止脆性材料崩裂),垂直夹具保证截面垂度。
镶嵌:真空镶嵌机(Fpress 30C auto)配合环氧树脂,微孔隙填充率达99.8%,气泡去除度99.5%,确保薄层边缘不塌陷。
磨抛:全自动磨抛机(Fpol 252A pro)逐级研磨后,使用1μm金刚石+0.25μm二氧化硅抛光。

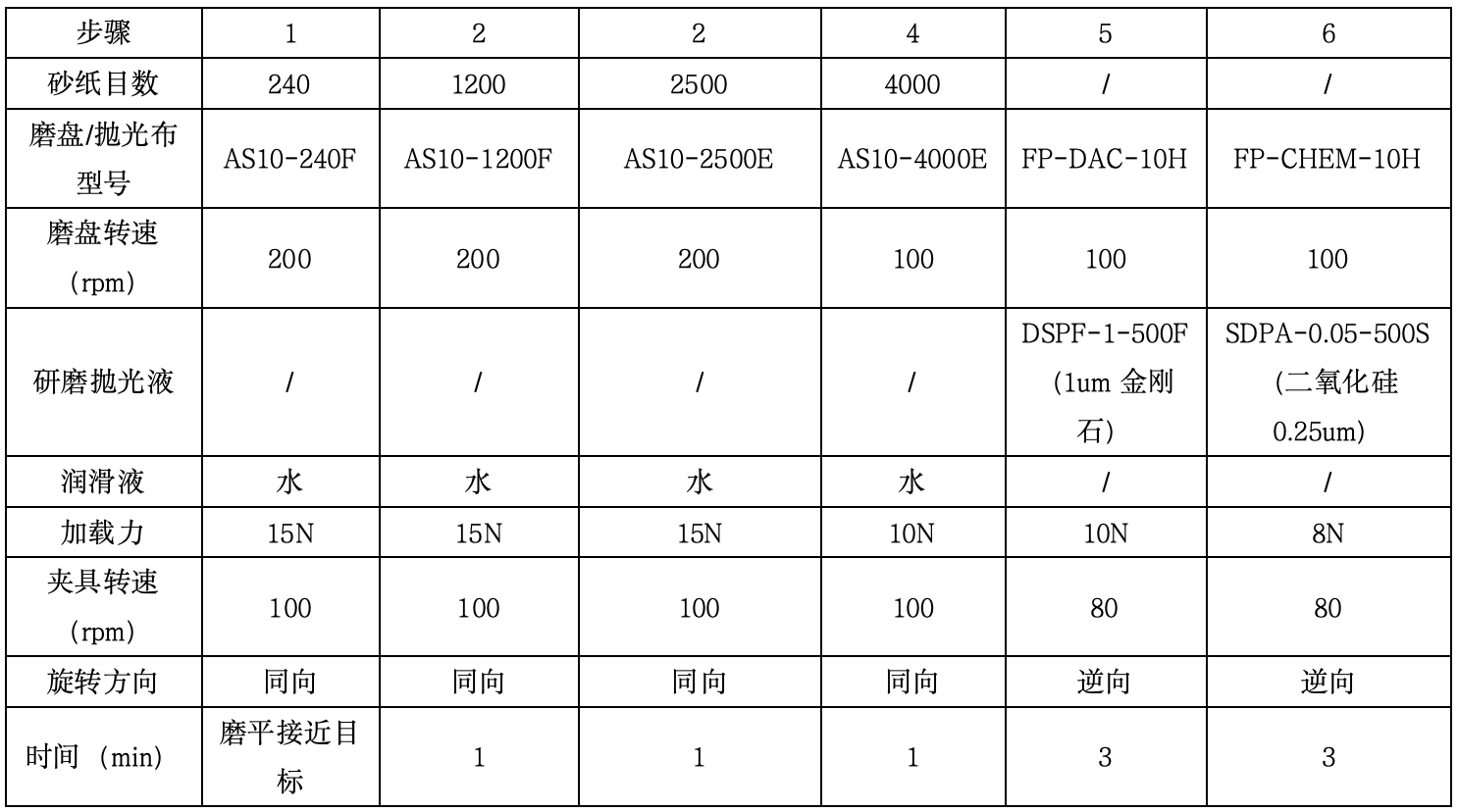
观察:研究级正置金相显微镜BM100G明场观察,可以看到试样磨抛面时平整无划痕各层叠构分明。


6.激光器芯片
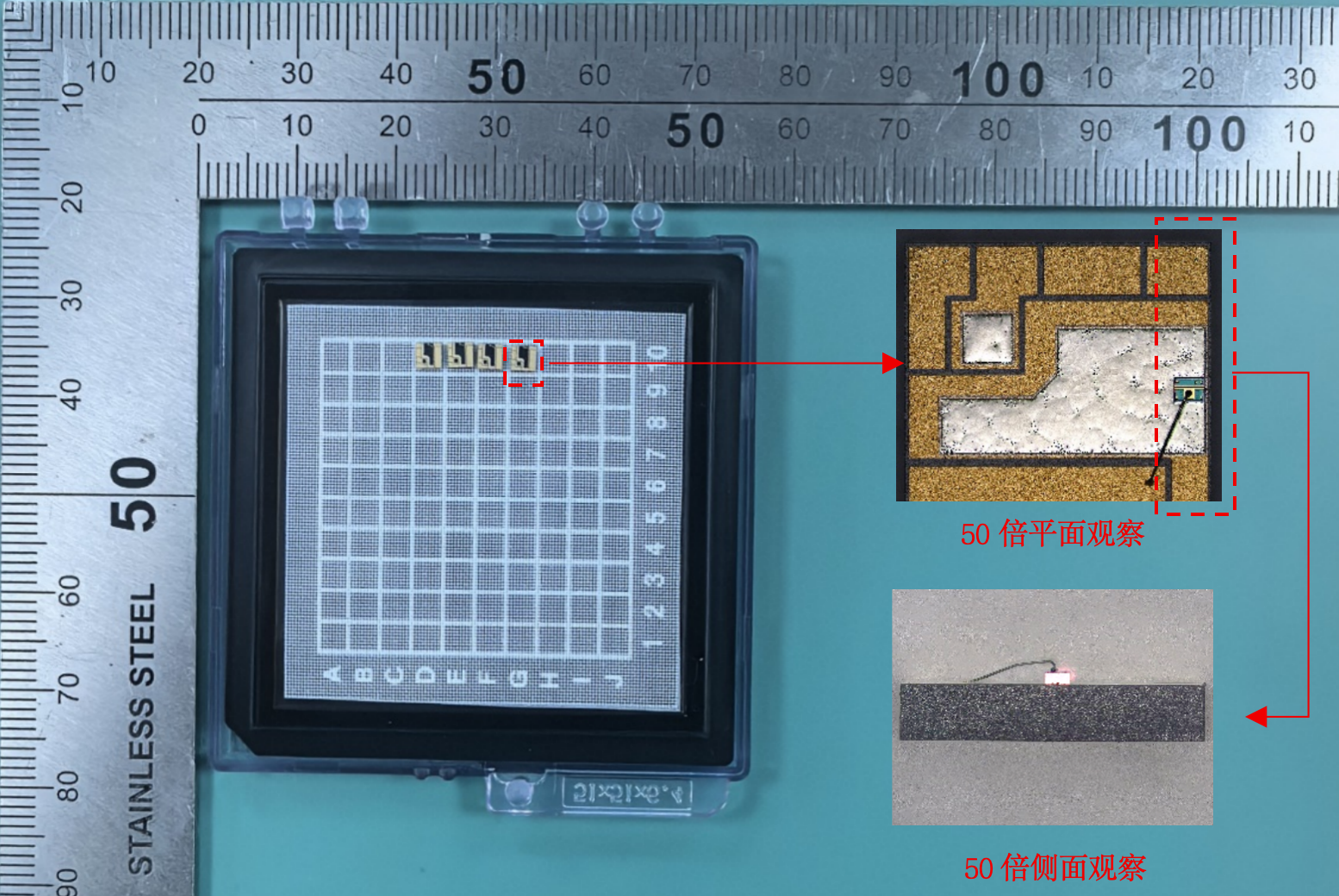

检测目标:去除芯片表面一定厚度(红框区域),为EMMI(发射光显微镜)测试导通做准备,同时保证抛光面无划痕、无应力层。
镶嵌:光固化镶嵌机(Fpress 30UV)+ UV树脂(FUH1000),1-2min快速固化,效率优先。
磨抛:特别注意在1200目后多次观察,确认芯片基板已磨掉再进行下一道。


观察:研究级正置金相显微镜BM100G,100倍下检查金线与硅片界面抛光质量,表面平整无残留划痕。


关键工艺参数对比及选型原则
1.切割
精密切割机是电子器件取样的主流设备。

Fcut 230E 手自一体精密切割机
切割速度需根据样品特性设定:柔性基材或脆性材料宜采用0.1-0.3 mm/s的低速,常规样品可采用1-2 mm/s。切割片类型方面,树脂金刚石片适用于金属与脆性材料,碳化硅片适用于一般树脂基封装。
2.镶嵌


Epress 30V Pro压力型冷镶嵌机 Fpress 30UV光固化镶嵌机
镶嵌树脂与工艺的选择直接决定最终观察面的真实性。
选型原则:常规检测优先考虑光固化方案以提升效率;需要高保真边缘保护时采用环氧树脂压力镶嵌;含微孔隙的样品(如底部填充胶层)则需真空处理配合低粘度树脂。
3.磨抛

Fpol 252A auto 全自动磨抛机
磨抛的核心原则为“逐级减力”。各案例的载荷变化序列均呈现随砂纸目数升高而递减的趋势,起始载荷15-30 N,终载荷5-10 N。磨盘转速多设为100-300 rpm,夹具转速80-150 rpm,最后1-2道抛光采用逆向旋转。目标定位精度较高的样品(如芯片晶圆,目标尺寸约42 μm)需在研磨过程中增加观察频次,以1200目为关键检查节点。
小结
-Conclusion-
(1)金相切片技术适用于PCBA焊点、LED封装、芯片晶圆、智能卡模块、底部填充胶、微型贴片元件及激光器芯片等七类电子器件的截面分析,制样参数需根据样品的尺寸、材料组成及检测目标分别设置。
(2)镶嵌方案的选择遵循以下规律:常规检测采用光固化方案(1-2 min);高边缘保真要求采用环氧树脂压力镶嵌(2 bar);含微孔隙样品需采用真空处理配合低粘度树脂。
(3)磨抛参数需遵循“逐级减力”原则,载荷序列随砂纸目数升高而递减,起始载荷15-30 N,终载荷5-10 N。定位精度要求较高的样品应在1200目节点增加观察频次。
(4)金相切片为电子器件失效分析提供基础的截面观测数据,其制样质量直接影响后续SEM/EDS等高阶分析的准确性。方案设计需基于样品特性进行定制化工艺配置。
Copyright © 2021 All Rights Reserved 版权所有苏州费马科仪自动化技术有限公司 苏ICP备19051203号  苏公网安备32059002004994号 网站制作:汇成传媒
苏公网安备32059002004994号 网站制作:汇成传媒